Cleaning
#시작하며
해당 포스팅에서는, 다음 공정단계로 넘어가기 전에, 공정 단계 사이사이에서 진행되는 Cleaning 공정에 대해 공부해볼 것이다. 앞서 공부했던 공정 단계를 설명하는 과정에서 자주 등장하기도 하였으며, 계속해서 진행해주어야 하는 공정이기 때문에 그 과정과 구성이 중요하다.

세정공정은 약 400~500개의 반도체의 매인 공정 중 15%를 차지하는 중요한 공정이다. Fab공정을 진행하면, 물리적/화학적 잔류물이 남게 되는데, 해당 잔류물을 제거하는 공정이 바로 세정(Cleaning)이다. 세정이 제대로 이루어지지 않으면, 제품의 성능과 신뢰성에 치명적인 악영향을 끼치고, 수율이 떨어져 다음 공정으로 진행되는 양품의 개수가 줄어들기 때문에, 품질 저하를 일으켜 고객 불만이 높아지는 경영상의 문제로 직결된다. 계속해서 나노공정이 발전함에 따라, 참호는 보다 깊고 좁아지기 때문에, 기술이 세밀화될수록 세정의 중요성이 더욱 부각되고 있다.
#세정(Cleaning) 공정

세정(Cleaning)은 크게 3가지로 구분 지을 수 있다. 화학용액을 이용하는 습식세정, 용액 이외의 매체를 이용하는 건식세정, 습식세정과 건식 세정의 중간 형태인 증기를 이용하는 증기 세정이 있다. 세정공정에는 특히 잔류물이 어떤 성질을 갖고 있는지에 대해 우선적으로 확인이 필요하다.
* 웨이퍼 표면의 잔류물
- 포토공정 후 남은 PR(감광액) 찌꺼기
- 식각공정 시 제거되지 않은 산화막
- 공중의 부유물이 내려앉은 Particle
- 앞 공정에서 사용된 유기물과 금속의 잔류물
- 세정공정 시 2차적으로 반응하여 붙어있는 화학물질 등
이렇게 웨이퍼의 표면에 다양한 잔류물이 남아있기 때문에, 웨이퍼 세정 시, 한 가지의 방식만 사용하지 않고, 위의 세 가지 세정을 진행하는 것이다. 사전에 습식과 건식을 복합적인 매트릭스로 맞추어 설정하고, 이를 검토하여 해당 잔류물이 웨이퍼 표면에서 완벽히 제거된다고 판단될 경우에 세정을 진행한다.
- Wet Cleaning
습식세정은 반도체 세정공정에서 가장 빈번하게 사용되는 기본적인 방식이다. 비용이 적게들고 공정 방식이 간단하다는 장점으로 아직까지는 습식세정이 주류를 이루고 있지만, 세정 이후 린스(Rins)와 건조(Dry)를 시켜야 하는 단점이 있고, 습식세정으로는 제거가 완벽하게 되지 않는 경우가 많아지면서 건식 세정을 함께 사용하는 방식이 늘어나고 있다. 건식 세정을 진행하더라도 주로 습식으로 마무리 세정을 하기 때문이다. 습식세정은 주로 과산화수소(H2O2) 계열의 세정으로 발전했지만 이후 오존(O3) 등 다른 요소를 적용하는 습식세정도 등장했다. 오존 세정은, 습식세정의 과산화수소 계열 액체 세정량을 과감히 줄일 수 있는 장점이 있다.

습식세정의 기본토대는 1970년대 Kern과 Puotinen에 의해 발표된 RCA 기관 세정공정이라 할 수 있다. 암모니아인 염기성을 주로 사용하는 SC1과 염산인 산성용액을 사용하는 SC2방법 등 과산화수소를 주축으로 다른 여러 세정 물질을 섞어, 식각을 추가로 진행하거나 세정 효율을 높이는 방식으로 다양화되었다.
미세화 패턴에 따라 세정방식의 변화도 일어났다. 회로 선폭 100nm 이후로 Aspect Ratio(높이/밑변) 값이 상승하여 세정용액이 트렌치 혹은 Via hole의 밑바닥까지 내려가지 못하는 결함이 발생되어, 더 이상 높은 Aspect Ratio에서는 습식세정이 불가능하여 새로운 세정방식의 필요성이 대두되었다. 이에 대안으로, 구조물과 외형 변화, 식각 영역에 상관없이 모두 세정이 가능한 건식 세정이 제시되었다. 건식 세정은 여러 가지 방식으로 분화가 가능하여 미세화에 따라 발전을 계속해서 거듭하고 있다.
- Dry Cleaning
습식세정은 여러가지 장점을 가지고 있지만, 구조의 미세화가 심화되고 세정액이 과다 사용되는 문제점이 있어, 액체보다는 기체를 사용하는 건식 세정이 계속해서 부각되어왔다. 건식은 습식에 비해 투자비용이 많이 들고 장비가 다루기 복잡하며, 방식 또한 까다롭지만, 표면에 잔류하는 PR, 산화막 등을 제거하는데 탁월하다. 더욱 다양화하여 초음파(습식 + 비 습식: 세정액 상태에서 초음파 공급)를 사용하거나 레이저, 드라이아이스, 자외선 혹은 최근에는 플라즈마를 사용하는 강력한 건식 세정으로 진화하고 있다.
#오염의 종류
그렇다면 앞서 웨이퍼에 잔류하며 세정의 필요성을 야기하는 공정과정에서 발생하는 오염물질은 어떤 것들이 있을까?
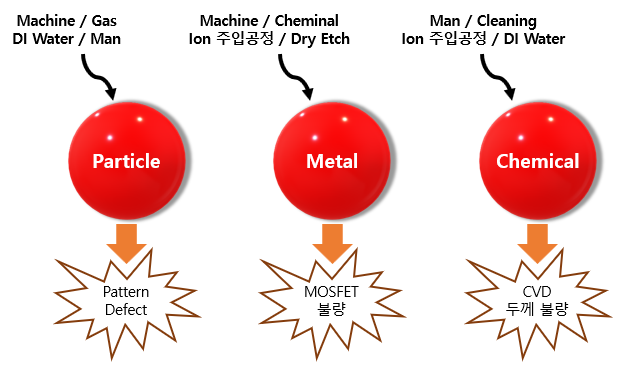
반도체 공정에서 오염의 종류로는 Machine / Gas / DI Water / Man에 의해 오염이 발생하는 Paticle이 있고, 이는 치명적인 결함인 Pattern Defect를 야기한다. 또한 Machine / Chemical / Ion 주입공정 / Dry Etch으로 발생하는 Metal의 오염은, MOSFET 불량을 일으키며, Man / Cleaning / Ion 주입공정 / DI Water로서 Chemical 오염이 발생하고, 그에 따른 결과로 앞서 공부했던 CVD과정에서 두께 불량을 일으킬 수 있다.
#마치며
오늘은 공정과정 중에 발생할 수있는 오염이나 잔류물들에 대한 결함을 방지하는 Cleaning 공정에 대해 공부하였다. 웨이퍼 표면에 잔류물에 대한 세정공정이 제대로 이루어지지 않으면, 치명적인 불량으로 이어지기 때문에 세정(Cleaning)의 중요성은 미세화가 진행될수록 중요해지고, 어려워지고 있다. 세정의 중요성과 기술이 발전함에 따라, 오염의 종류, 제품 상태를 검토하여 각 제품에 알맞은 세정 방법과 절차를 마련해야 한다.
'반도체 공정' 카테고리의 다른 글
| 반도체 TEST공정 (0) | 2021.08.12 |
|---|---|
| 반도체 공정 - MI(Measurement & Inspection) (0) | 2021.08.09 |
| 반도체 공정 - 박막 공정(CVD) (1) | 2021.08.05 |
| 반도체 공정 - 박막 공정(PVD) (0) | 2021.08.05 |
| 반도체 공정 - 식각(Etching)-2 (0) | 2021.08.04 |